Thin Film Deposition
HV Evaporator
Plassys MEB 550S
The MEB 550S electron beam evaporator with fully automated control. For reduced pumping time the machine has a load lock and is capable of processing substrates up to 4″. The substrate holder can be adjusted in an angel to the source with an accuracy of 0.01°. It also can rotate around it’s own axis. For cleaning/etching substrates the evaporator has an ion gun with which an O2 or Ar/O2 plasma can be created. The accuracy of the deposition rate is determined by an oscillating crystal and is up to 0.01nm/s.
Available Metals: Al, Au, Pd, Pt, Ti, Cr, Re, Nb, Granular Al

User Support and Scientific Advice:
Carola Rando carola.rando@ist.ac.at
Lubuna Shafeek lubuna.shafeek@ist.ac.at
Nasima Afsharimani nafshari@ista.ac.at
UHV Evaporator
Plassys MEB 550S2
The MEB 550 S2 is a UHV type evaporator with three chambers. This computer controlled evaporation tool dedicated for fabrication of quantum devices. It has a high precision tilting/rotating sample holder for shadow evaporation, and oxygen gas inlet for oxidation of tunnel barriers. The source chamber is cryo pumped and separated from the sample chamber by a gate valve. The sample chamber is turbo pumped, and is equipped with an ion gun for sample pre-cleaning and etching.
Allowed metals: Al, Nb, Ti

- Source chamber with a linear 4x 15 cc UHV ebeam source
- Treatment chamber above the source chamber
- Lateral Sample load lock for a 4″ substrate
- Possibility for in-situ oxidation
User Support and Scientific Advice:
Nasima Afsharimani nafshari@ista.ac.at
Bruno Magalhaes bmartins@ist.ac.at
Juan Aguilera juan.aguilera@ist.ac.at
Atomic Layer Deposition (ALD)
Oxford FlexAL: ALD
The Oxford FlexAL systems provide a new range of flexibility and capability in the engineering of nanoscale structures and devices by offering remote plasma atomic layer deposition (ALD) processes and thermal ALD within a single system. This system deliver maximum flexibility in the choice of materials and precursors, low-temperature processes enabled by plasma ALD, and repeatable processes via recipe-driven software interface.
Currently installed precursors: for HfO2 and Al2O3 deposition.
- Tetrakislethylmethylaminolhafnium (IV)
- Trimethylaluminium
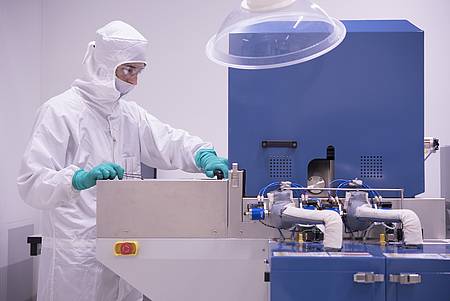
- Remote plasma & thermal ALD in one flexible tool
- Automated 200mm load lock for process flexibility
- Low-temperature processes enabled by plasma ALD
- Low damage maintained by the use of remote plasma
- Ability to handle from small wafer pieces up to full 200mm wafers
- Integral glove box on precursor modules for in-situ change-over
- Max deposition temperature 400ºC
- ICP source 300W at 13.56 MHz
- Electrode diameter 240 mm
User Support and Scientific Advice:
Rodolfo Previdi rodolfo.previdi@ist.ac.at
Juan Aguilera juan.aguilera@ist.ac.at
Lubuna Shafeek lubuna.shafeek@ist.ac.at
HV Sputtering
AJA Orion 8
The AJA Orion 8 Sputtering System is capable of depositing metal and insulating films with RF generators and three DC generators. Each sputtering sources has integral isolation chimneys, pneumatic shutters and individual gas injection capability. The tool is equipped with a load lock and sputtering chamber with manual sample transfer and computer-controlled deposition. Reactive sputtering with oxygen also available as well. Substrate holder mounts to top of and accommodates substrates up to 4″ diameter. It has continuous motorized rotation (0-40RPM) with controller and radiant heating to 850° C with quartz halogen lamps. Substrate lift for load-lock transfer and working distance adjustment via edge welded bellows also possible.
System specification:
- Process Gases: Ar (0 – 50 sccm) and O2 (0 – 20 sccm)
- RF-Magnetron: 300 Watts maximum
- DC-Magnetron: 750 Watts maximum
- Available targets: Available Targets: Au, Pd, Ti, Cr, ITO, ZnO, Ni, CuNi
- Load-lock pressure: 3.8 x 10-6 Torr and Process chamber pressure: 4.8 x 10-8 Torr

User Support and Scientific Advice:
Nasima Afsharimani nafshari@ista.ac.at
Lubuna Shafeek lubuna.shafeek@ist.ac.at
Bruno Magalhaes bmartins@ist.ac.at
UHV Sputtering
ATC-2200-UHV
The AJA ATC-2200-UHV Sputtering System is capable of depositing metal and insulating films with seven 2 inch and one 4 inch magnetron sputtering sources. Each sputtering sources has integral isolation chimneys, pneumatic shutters and individual gas injection capability via port on cluster flange. The tool is equipped with a load lock and sputtering chamber with manual sample transfer and computer-controlled deposition. Reactive sputtering with Nitrogen also available as well. Substrate holder mounts to top of chamber for sputter up orientation and accommodates substrates up to 4″ diameter. It has continuous motorized rotation (0-40RPM) with controller and radiant heating to 850° C with quartz halogen lamps. Substrate lift for load-lock transfer and working distance adjustment via edge welded bellows also possible.
System specification:
- Process Gases: Ar (0 – 50 sccm) and N2 (0 – 20 sccm)
- RF-Magnetron: 600 Watts maximum
- DC-Magnetron: 1500 Watts maximum
- Available targets: Available Targets: NbTi, Ta, Nb, W, Al, Ti and SiO2
- Load-lock pressure: 3.8 x 10-6 Torr and Process chamber pressure: 2 x 10-9 Torr

User Support and Scientific Advice:
Bruno Magalhaes bmartins@ist.ac.at
Nasima Afsharimani nafshari@ista.ac.at
Carola Rando carola.rando@ist.ac.at
Desktop Sputtering system
VacTechnishe DST3-T
The VacTechnishe DST3-T is a three-target, turbo molecular-pumped, multi-vacuum coater system housed in a single small desktop unit. The VacTechnishe DST3-T is capable of depositing a wide range of materials, including metals, semiconductors, and ceramics, due to its three 2″ magnetron cathodes, of which, two DC generators, and one RF generator. The DST3-T has three angled cathodes and may perform deposition from two cathodes at the same time, allowing for co-sputtering. The substrate holder can accommodate substrates up to 3″ in diameter for depositions at various temperatures, and its rotation allows for very good layer uniformity.
System specification:
- Process gas: Ar
- Available targets: Cr, Se, PTFE, PVD
- RF- Magnetron: 300 W maximum
- DC Magnetron: 600 W maximum
- Vacuum pressure: 2 × 10-6 < P < 2 × 10-5
- Sputtering vacuum range: 5 × 10-2 < P < 5 × 10-3
- Substrate holder rotation speed: 6 to 12 rpm
- Substrate holder temperature: 500 °C

User Support and Scientific Advice:
Bruno Magalhaes bmartins@ist.ac.at
Carola Rando carola.rando@ist.ac.at
Lubuna Shafeek lubuna.shafeek@ist.ac.at


